Ионно-плазменная очистка поверхности
- от объёма, заполните заявку
Ионно-плазменная очистка — технологический процесс удаления загрязнений с поверхности материалов путём бомбардировки ускоренными ионами рабочего газа в условиях вакуума. Метод применяется для подготовки подложек перед нанесением тонкоплёночных покрытий, в производстве изделий микроэлектроники, оптики и при гальванической обработке.
В отличие от химической очистки растворителями, ионно-плазменная обработка не оставляет остатков на поверхности, позволяет удалять загрязнения на молекулярном уровне и активирует поверхность для улучшения адгезии наносимых покрытий.
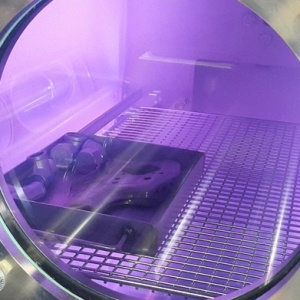
Физические механизмы ионно-плазменной очистки
Процесс основан на взаимодействии ионов рабочего газа с поверхностью обрабатываемого материала. В вакуумной камере создаётся газоразрядная плазма, из которой электрическим полем извлекаются и ускоряются положительные ионы. При столкновении с поверхностью ионы передают кинетическую энергию атомам загрязнений, выбивая их с поверхности, или инициируют химические реакции с образованием летучих продуктов, откачиваемых из камеры.
Физическое распыление (катодное распыление)
При использовании инертных газов — аргона, криптона, ксенона — ионы при соударении с поверхностью передают импульс атомам загрязнений, выбивая их с поверхности. Этот механизм эффективен для удаления физических загрязнений: частиц пыли, адсорбированных молекул воды, механических примесей, а также тонких оксидных плёнок. Скорость удаления материала и степень воздействия на подложку определяются массой иона, его энергией и углом падения.
Плазмохимическая очистка
При подаче химически активных газов — кислорода, водорода, азота, фторсодержащих соединений — активные радикалы и ионы, образующиеся в плазме, вступают в химические реакции с загрязнениями на поверхности. Продукты реакций переходят в газовую фазу и удаляются откачной системой. Кислородная плазма окисляет углеводородные соединения до CO₂ и H₂O; водородная плазма восстанавливает оксидные плёнки на металлах. Плазмохимическая очистка удаляет тонкие органические плёнки толщиной в единицы нанометров — там, где физическое распыление недостаточно селективно.
На практике применяется комбинированный подход: смесь инертного и реактивного газов обеспечивает одновременное физическое и химическое воздействие. Это повышает эффективность процесса и снижает время обработки по сравнению с каждым из механизмов в отдельности.
Параметры технологического процесса
Эффективность ионно-плазменной очистки определяется комплексом взаимосвязанных параметров, которые подбираются под конкретный материал и тип загрязнений.
Рабочее давление в камере — от 10⁻² до 10 Па в зависимости от метода генерации плазмы и режима обработки. При слишком низком давлении разряд не поддерживается; при чрезмерно высоком — ионы теряют энергию на столкновениях с молекулами газа до достижения обрабатываемой поверхности.
Напряжение разряда в установках с тлеющим разрядом составляет 400–900 В. Энергия ионов, достигающих обрабатываемой поверхности, определяется катодным падением потенциала: в системах с тлеющим DC-разрядом она близка к напряжению разряда. В установках с автономными ионными источниками применяются ускоряющие напряжения от 0,5 до 5 кВ.
Плотность ионного тока влияет на интенсивность и скорость очистки. Для установок с тлеющим разрядом характерные значения плотности тока на обрабатываемой поверхности составляют до 8 мА/см².
Частота разряда при высокочастотной плазменной обработке стандартно составляет 13,56 МГц (ISM-диапазон, принятый для промышленных плазменных установок). Низкочастотные системы работают на частоте 40 кГц. Выбор частоты определяет возможность обработки диэлектрических материалов без накопления поверхностного заряда — постоянный ток этого обеспечить не может.
Рабочие газы для ионно-плазменной обработки
Выбор рабочего газа определяется материалом обрабатываемой поверхности, типом удаляемых загрязнений и допустимым воздействием на подложку.
Инертные газы
Аргон — наиболее распространённый рабочий газ для физического распыления. Оптимальное соотношение атомной массы, доступности и стоимости делает его универсальным выбором для очистки металлических поверхностей, удаления оксидных плёнок и подготовки подложек перед напылением.
Неон применяется при очистке лёгких материалов: меньшая масса иона снижает коэффициент распыления подложки по сравнению с аргоном. Криптон и ксенон используются для интенсивного распыления материалов с высокой атомной массой — их тяжёлые ионы обеспечивают более эффективную передачу импульса.
Реактивные газы и их смеси
Кислород — основной газ для удаления органических загрязнений. Активные радикалы кислородной плазмы окисляют углеводородные соединения до CO₂ и H₂O, которые откачиваются из камеры. Применяется при подготовке поверхностей перед пайкой, склеиванием и нанесением покрытий.
Водород используется для химического восстановления оксидных плёнок на металлических поверхностях — меди, серебра и других металлов, склонных к окислению. В отличие от физического распыления, водородная плазма восстанавливает оксидный слой без значительного удаления основного металла.
Азот применяется при обработке материалов, для которых недопустимо окисление поверхности. Химически относительно инертен к большинству металлов при комнатной температуре, обеспечивает физическую очистку без введения кислородсодержащих функциональных групп.
Фтор- и хлорсодержащие газы (CF₄, SF₆, NF₃) применяются в микроэлектронике для плазмохимического травления кремния и удаления специфических диэлектрических загрязнений. Работа с этими газами требует оборудования для нейтрализации токсичных выбросов и соответствующих мер безопасности.
Области применения ионно-плазменной очистки
Подготовка поверхности перед нанесением покрытий
Ионно-плазменная очистка — обязательный этап перед вакуумным напылением, магнетронным распылением (PVD) и ионно-плазменным осаждением. Качество очистки напрямую определяет адгезию наносимых покрытий.
Плазменная обработка поверхности подложек непосредственно перед осаждением позволяет получить адгезию покрытий, сравнимую с когезионной прочностью подложки: разрушение при испытаниях происходит не на границе раздела покрытие–подложка, а внутри материала. Достигается это за счёт создания на поверхности активных центров адсорбции, а также инициирования химического взаимодействия между материалом плёнки и подложкой.
Микроэлектроника и полупроводниковое производство
В производстве интегральных схем ионно-плазменная очистка применяется для удаления естественных оксидов с поверхности монокристаллических кремниевых пластин перед нанесением технологических слоёв, подготовки к процессам осаждения и травления, удаления остатков фоторезиста после литографических операций.
При производстве СВЧ-компонентов, гироскопов, фильтров на поверхностных акустических волнах (ПАВ) и микросборок плазменная очистка обеспечивает необходимую чистоту межфазных границ для надёжной работы изделий.
Оптика и фотоника
В производстве оптических элементов плазменная обработка применяется для подготовки поверхности линз, зеркал и светоделителей перед нанесением просветляющих, отражающих и поглощающих покрытий. Особенность обработки оптических материалов — необходимость сохранения параметров поверхности (шероховатость, геометрия) при полном удалении загрязнений.
Для очистки полимерных оптических элементов применяются специальные низкотемпературные режимы с использованием импульсной плазмы, позволяющие избежать термической деформации подложки.
Гальваническое производство
Перед нанесением гальванических покрытий ионно-плазменная очистка позволяет удалить пассивные оксидные плёнки с металлических поверхностей. Это особенно важно при работе с нержавеющими сталями, титаном, алюминием — металлами, склонными к образованию устойчивых защитных оксидных слоёв, которые препятствуют адгезии гальванического покрытия.
Типичные применения: подготовка металло-керамических и стеклокерамических корпусов перед монтажом, удаление пассивного слоя с золотого покрытия перед пайкой, очистка металлизации на оптических элементах перед герметизацией. Для самих гальванических процессов применяются специальные аноды различных типов в зависимости от осаждаемого металла и состава электролита.
Инструментальное производство и машиностроение
Ионно-плазменная очистка применяется при подготовке режущего инструмента перед нанесением износостойких покрытий — нитрида титана, карбонитрида титана, алмазоподобных покрытий. Качество предварительной очистки определяет равномерность и долговечность упрочняющего покрытия.
В производстве деталей газотурбинных двигателей плазменная очистка применяется перед нанесением жаростойких и теплозащитных покрытий на лопатки турбин.
Медицинские изделия
При производстве имплантатов обработка в кислородной плазме повышает поверхностную энергию и гидрофильность титана. Это способствует остеоинтеграции — врастанию имплантата в костную ткань за счёт улучшения взаимодействия поверхности с белками костного матрикса.
Типы установок для ионно-плазменной очистки
Установки с тлеющим DC-разрядом
Обрабатываемое изделие размещается на катоде или вблизи него. Ионы из плазмы тлеющего разряда ускоряются катодным падением потенциала и бомбардируют поверхность. Рабочее давление — 10⁻¹–10⁻² Па, напряжение — 400–900 В, плотность тока — до 8 мА/см². Метод применим только к токопроводящим материалам: постоянный ток не позволяет обрабатывать диэлектрики из-за накопления заряда на поверхности.
Установки с высокочастотным разрядом (ВЧ, RF)
Переменное электрическое поле частотой 13,56 МГц нейтрализует положительный заряд, накапливающийся на поверхности диэлектрика при взаимодействии с ионами. Это позволяет обрабатывать стекло, керамику, полимерные материалы. За счёт эффекта автоматического смещения (self-bias) на подложке устанавливается отрицательный потенциал, ускоряющий ионы к обрабатываемой поверхности. Низкочастотные системы (40 кГц) применяются для металлических изделий и крупногабаритных партий.
Установки с индуктивно-связанной плазмой (ICP)
Плазма создаётся радиочастотным индуктором, расположенным снаружи камеры через диэлектрическое окно. Это обеспечивает высокую плотность плазмы при относительно низкой энергии ионов. Раздельное управление плотностью плазмы и энергией ионов позволяет вести интенсивную химическую обработку поверхности с минимальным физическим повреждением подложки. Применяются в микроэлектронике, где высокая скорость процесса сочетается с требованием сохранения топологии поверхности.
Установки с удалённой плазмой
Плазма генерируется в отдельной камере, а активные нейтральные частицы (радикалы) транспортируются к обрабатываемому образцу. Ионная бомбардировка, УФ- и рентгеновское излучение плазмы на обрабатываемую поверхность не воздействуют. Применяются для обработки чувствительных полупроводниковых структур и органических покрытий, где радиационное повреждение недопустимо.
Технологические ограничения и особенности процесса
Неселективность ионной бомбардировки. Ионы удаляют не только загрязнения, но и материал подложки. Скорость распыления подложки зависит от её атомной массы и параметров процесса. При необходимости защиты отдельных участков применяются маскирующие покрытия.
Необходимость предварительной подготовки. Ионно-плазменная очистка эффективна на финальном этапе подготовки поверхности. Грубые загрязнения — масла, смазки, крупные частицы — должны быть удалены химическими или механическими методами до плазменной обработки.
Ограниченное время хранения очищенной поверхности. Активированная поверхность адсорбирует загрязнения из атмосферы. Нанесение покрытий рекомендуется проводить непосредственно после плазменной очистки, идеально — в той же вакуумной камере без нарушения вакуума.
Встраивание рабочего газа в поверхность. При интенсивной ионной бомбардировке атомы рабочего газа могут имплантироваться в поверхностный слой подложки. Для чувствительных к газовым примесям материалов этот фактор учитывается при подборе режима очистки.
Перечень марок нашей номенклатуры
RCuSi-A · C 2680 P · L 10 As · ADC10Z · P-CuZn30 · Nickel 230 · A5.14 (EQNiCrMo-13) · ХН45Ю · EN AM-92901 · Al-Mg3A · B 315 (C 61300) · 2280 · AlMg5Si1 · 3.0285 · ЭП538 · 5405



